現代のチップが熱くなる理由
ナノスケールのトランジスタがギガヘルツの速度でスイッチングすると、電子は回路を駆け巡り、熱としてエネルギーを失います。これは、ノートパソコンやスマートフォンが不快なほど熱くなったときに感じるのと同じ熱です。チップ上にトランジスタを詰め込むほど、熱を逃がすスペースが少なくなります。熱はシリコン全体に均等に広がるのではなく、周囲よりも数十度も高温になるホットスポットに蓄積されます。損傷やパフォーマンスの低下を防ぐため、システムは温度が急上昇するとCPUとGPUの速度を制限します。
熱チャレンジの範囲
小型化競争として始まったものが、あらゆる電子機器における熱との戦いへと変化しました。コンピューティングにおいては、性能向上に伴い電力密度はますます高まり、個々のサーバーは数十キロワット規模の電力を消費します。通信においては、デジタル回路とアナログ回路の両方において、より強力な信号とより高速なデータ伝送のために、より高いトランジスタ電力が求められます。パワーエレクトロニクスにおいては、効率向上は熱的制約によってますます制限されるようになっています。
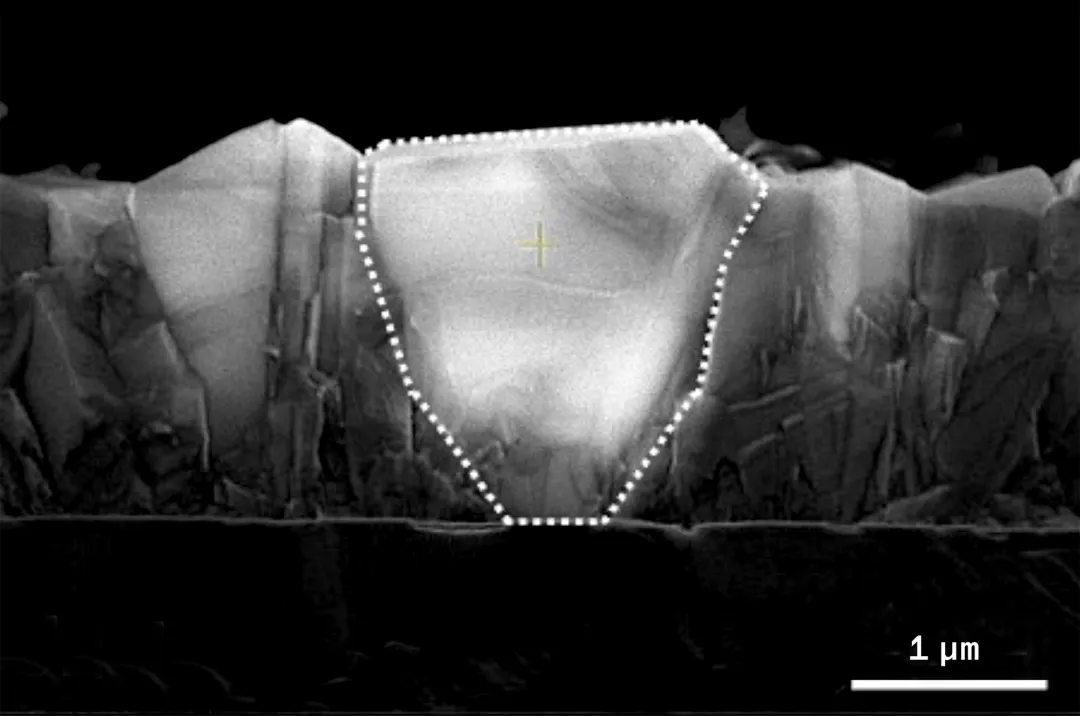
別の戦略:チップ内部に熱を拡散させる
熱を集中させるのではなく、有望なアイデアは希薄熱湯をプールに注ぐようなもので、チップ自体に熱を分散させる必要があります。熱が発生した場所に直接拡散すれば、最も高温になるデバイスの温度が下がり、従来の冷却装置(ヒートシンク、ファン、液体ループ)がより効果的に機能します。そのためには、高熱伝導性、電気絶縁性材料アクティブトランジスタの繊細な特性を損なうことなく、わずかナノメートルの集積度で集積されたチップ。意外な候補がこれに当てはまります。ダイヤモンド.
なぜダイヤモンド?
ダイヤモンドは、銅の数倍もの優れた熱伝導率を持つ、既知の材料の中でも最も優れた熱伝導率を持つ物質の一つです。しかし、電気絶縁体でもあります。問題は集積度です。従来の成長方法では900~1000℃以上の温度が必要であり、高度な回路に損傷を与える可能性があります。最近の進歩により、薄い多結晶ダイヤモンドわずか数マイクロメートルの厚さの薄膜をはるかに低い気温完成したデバイスに適しています。

今日のクーラーとその限界
主流の冷却技術は、ヒートシンク、ファン、インターフェース材料の改良に重点を置いています。研究者たちは、マイクロ流体液体冷却、相変化材料、さらには熱伝導性と電気絶縁性を備えた液体にサーバーを浸漬させることも研究しています。これらは重要なステップですが、かさばったり、高価だったり、新興技術との相性が悪かったりする可能性があります。3Dスタックチップアーキテクチャでは、複数のシリコン層が「超高層ビル」のように機能します。このような積層構造では、すべての層が熱を放出する必要があります。そうしないと、内部にホットスポットが閉じ込められてしまいます。
デバイスフレンドリーなダイヤモンドを育てる方法
単結晶ダイヤモンドは並外れた熱伝導率(≈2200~2400 W m⁻¹ K⁻¹、銅の約6倍)を誇ります。より容易に製造できる多結晶膜は、十分な厚さがあればこの値に近づくことができ、さらに薄くても銅よりも優れています。従来の化学気相成長法では、メタンと水素を高温で反応させ、垂直のダイヤモンドナノコラムを形成します。このナノコラムは後に膜に融合しますが、その時点では層が厚くなり、応力がかかり、割れやすくなっています。
低温成長には異なるレシピが必要です。単に温度を下げるだけでは、絶縁性のダイヤモンドではなく導電性の煤が生成されます。酸素非ダイヤモンド炭素を連続的にエッチングし、約400℃の大粒径多結晶ダイヤモンド高度な集積回路に適合した温度です。同様に重要なのは、このプロセスは水平面だけでなく、サイドウォールこれは本質的に 3D デバイスにとって重要です。
熱境界抵抗(TBR):フォノンボトルネック
固体中の熱はフォノン(量子化された格子振動)。物質界面ではフォノンが反射して積み重なり、熱境界抵抗(TBR)熱の流れを阻害する。インターフェースエンジニアリングはTBRの低減を目指しているが、半導体の互換性によって選択肢が限られる。特定のインターフェースでは、相互混合により薄い層が形成されることがある。炭化ケイ素(SiC)両側のフォノン スペクトルにより適合する層が「ブリッジ」として機能し、TBR を低減することで、デバイスからダイヤモンドへの熱伝達が改善されます。
テストベッド: GaN HEMT (無線周波数トランジスタ)
窒化ガリウムをベースとした高電子移動度トランジスタ(HEMT)は、2次元電子ガス中の電流を制御し、高周波・高出力動作(Xバンド ≈8~12GHz、Wバンド ≈75~110GHzを含む)に優れています。熱は表面のごく近くで発生するため、HEMTはあらゆるin-situ熱拡散層の優れたプローブとなります。薄いダイヤモンドがデバイス(側壁を含む)を覆っている場合、チャネル温度は約100℃低下することが観測されています。約70℃高出力時の熱ヘッドルームが大幅に改善されました。
CMOSと3Dスタックのダイヤモンド
高度なコンピューティングでは、3Dスタッキング集積密度と性能は向上するが、従来の外部冷却装置が効果を発揮しにくい内部熱ボトルネックが発生する。ダイヤモンドとシリコンを統合することで、再び有益な効果が得られる。SiC中間層高品質の熱インターフェースを実現します。
提案されているアーキテクチャの1つは熱足場: 誘電体内のトランジスタの上に埋め込まれたナノメートルの薄いダイヤモンドシートは、垂直サーマルビア(「ヒートピラー」)銅または追加のダイヤモンドで作られたこれらの柱は、層から層へと熱を伝え、外部の冷却装置に到達します。現実的な負荷でのシミュレーションでは、このような構造によりピーク温度を低下させることができることが示されています。1桁まで概念実証スタック内。
難しいのは
主な課題としては、ダイヤモンドの表面を原子的に平坦上部の相互接続部や誘電体とのシームレスな統合、および薄膜が下層の回路に負担をかけずに優れた熱伝導性を維持できるようにプロセスを改良します。
見通し
これらのアプローチが成熟し続けると、チップ内ダイヤモンド熱拡散CMOS、RF、パワーエレクトロニクスの熱制限を大幅に緩和し、通常の熱ペナルティなしに、より高いパフォーマンス、より高い信頼性、より高密度の 3D 統合を可能にします。
投稿日時: 2025年10月23日
